GaN基电源性能的简易测试技术
品慧电子讯今天,大多数电源路线图都将GaN晶体管作为一个关键平台集成到其中。与Si-mosfet、igbt和SiC-mosfet相比,GaN晶体管的优点意味着工程师们正在将它们广泛地设计到他们的系统中。然而,GaN晶体管在开关电源中的这些进步也使得表征这些电源的性能变得越来越具有挑战性。在半桥上测量高边VGS是诊断晶体管交叉导通的一种传统方法,对于基于GaN的设计来说是一项艰巨的任务。典型的解决方案是使用高成本的测量设备,这并不总是产生有用的结果。本文介绍了一种利用GaN晶体管的独特特性测量交叉导通的简单而经济的方法。
在升压或降压变换器和双向变换器中用于同步整流的半桥和全桥配置为高、低压侧晶体管使用互补驱动信号。驱动信号必须在半桥中的一个晶体管关闭和另一个晶体管打开之间包含少量的“死区时间”,以确保晶体管不会交叉导电。当半桥结构中的晶体管同时打开时,会发生交叉传导,这种情况会增加损耗,并可能损坏晶体管。增加死区时间有助于保护晶体管,但也会产生另一种类型的损耗,这种损耗会在两个晶体管都关闭时发生,从而降低电桥的效率并降低功率转换器的可用占空比范围。因此,在确保不发生交叉传导的情况下,尽量减少桥的停滞时间是一个关键的设计目标。验证此操作是一个挑战。
验证电源半桥拓扑是否正确交叉导通的常用方法是使用两个探针同时验证高压侧和低压侧驱动信号之间的死区时间。测量氮化镓晶体管驱动信号,特别是高边栅,是一项具有挑战性的工作,经常导致误触发,使设计工程师感到沮丧。
GaN器件的栅极信号具有很高的转换速率,约为1V/ns,这给使用传统的隔离探针进行高边测量带来了挑战。如果测量系统没有足够的共模抑制比(CMRR),则高压侧源节点共模电压的快速变化会产生干扰,使测量变得模糊。另外,传统的无源电压探针引入的寄生电容会使栅极驱动信号失真,从而导致交叉传导。
光学隔离测量系统,如Tektronix TIVH系列IsoVu,已开发出直流共模抑制比大于160分贝,以提供可实现的高压侧VGS测量解决方案。此类测量系统还必须最小化传感回路面积,并提供增强的屏蔽测量信号路径。为此,配备了微型电容转换器(cx)专用电路板,以提供所需功率的微型接口。图1显示了使用GS66516T GAN晶体管的高侧VGS测量结果和双脉冲测试板。TIVH系列IsoVu和MMCX连接器用于实现这一点,如图2所示。

图1左边的图表显示了使用Tektronix IsoVu测量系统在ILoad=23A下测量的不同Rgon的高压侧VG。右侧显示GS66516T双脉冲测试(DPT)板。

带MMCX连接器的PCB板(右)。
测量系统的成本以及信号路径的额外复杂性和灵敏度为更具成本效益和更不敏感的解决方案留下了空间。GaN系统工程师开发的一种方法只测量低端晶体管,解决了这些问题。
GaN半桥的典型硬开关开通过渡示意图如图3所示,代表性的低压侧ID曲线如图4所示。在电压换向期间(图3d),S1上的电压增加,S2上的电压降低。相应地,晶体管漏极至源电容器C1和C2将分别充电和放电。由于S2的二维电子气(2DEG)通道导通,而S1的2DEG通道被关闭,C1的充电电流流过S2,导致电流突增。

图3这些硬开关转换图显示了S1导电(a)、死区时间(b)、电流换向(c)、电压换向(d)和S2导电(e)。
由于GaN晶体管不像Si和SiC mosfet,没有固有的体二极管,因此在电压换向期间没有反向恢复损耗(图4中的t1~t2)。低侧漏极电流的缓冲区是来自相反开关S1的电容(COSS=CGD+CDS)充电电流IQ(OSS)的结果。
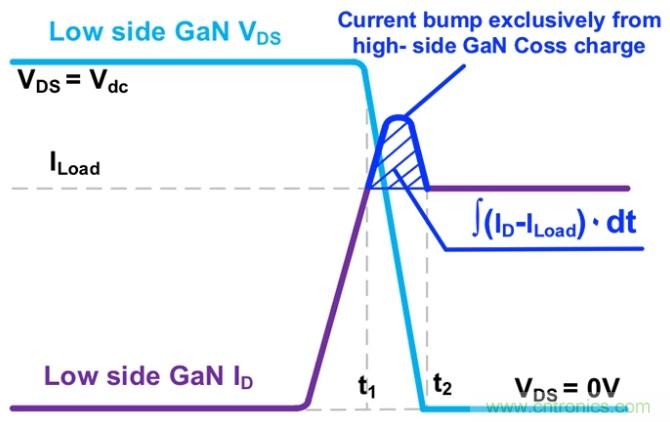
图4这是低边GaN晶体管的硬开关开启过程。
如果发生交叉传导,电流的碰撞面积将大于COSS的预期值。交叉传导可以在电压换向期间、之后、期间和之后同时发生(图5)。
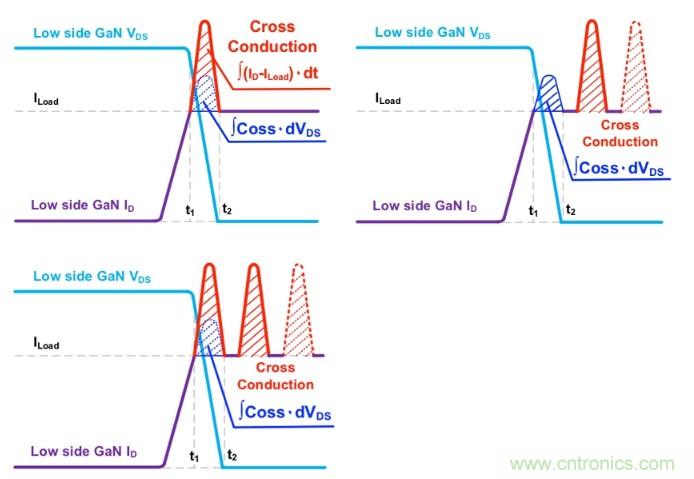
图5在电压换向期间、之后或两者同时发生交叉传导。
推荐阅读:
碳化硅FET推动了电力电子技术的发展
电机逆变器中功率半导体的作用
PK传统开关,MEMS开关的N大优势
对光学气体传感技术的介绍
贸泽成为e-peas能量收集PMIC产品的首家全球授权分销商
