功率半导体发展趋势
中心议题:
- 功率产品格局
- 功率分配的挑战
- 解决方案选择
- 功率的整合
功率产品格局
尽管大多数功率半导体仍然以传统的封装形式如TO220销售,但功率半导体领域的界限却日益变得模糊。本文将较为正确的描述这些界限。
在过去的数年间,功率产品格局发生了最为重大的转变,那就是功率半导体器件从用于诸如电动机、磁盘驱动器、电视线圈、荧光灯等的各种机电负载,向用于IC的纯电子负载转变。这种市场趋势曾经主要集中在功率半导体的产品创新,同时也创造了许多新的控制IC机会,从而诞生了一个新的代表性名词来描述这种市场:功率管理。功率管理市场不仅巨大,而且正在不断增长。
随着IC工艺的不断成熟,现在的Vcc 水平达到了难以置信的地步,而且IC功能的不断提高也能满足IC对更多电流供给的需要。本文将详细讨论功率管理方面存在的巨大差异。
电子负载
采用的功率管理方案通常取决于系统限制。例如,在某些设计中,电路板耗费的总功率正接近极限值,因此只能考虑那种能够提供极高散热效率或者不同散热路径的解决方案。在另外一些设计中,IC必须在数微秒内迅速从低电压的备用模式向满负荷处理功率模式转化,这就要求解决方案能够提供1000A/ms 甚至更高的 dI/dt。
功率分配的挑战
要让单一供给源产生1.5~1.2V范围的5路校准输出是不可能的。其挑战性在于输出路数的多少以及如何产生所需的剩余电压。亚洲制造的大多数应用器件如计算机、服务器、电视、DVD等都存在这种问题,这些器件通常采用单路或双路的功率供给来产生5V或12V的总线,从而通过总线获得较低的电压。在网络基础设施方面,功率要求现在面临两方面的挑战:5V总线上的电流增长使得 I2R耗损显得特别重要,但达到 12V后又会引起另外的新问题 - 从12V到1V比从5V到1V的转换效率要低得多。因此,争论的焦点在于各种中间总线电压的优点。
解决方案选择
尽管线性调节器产品可达到5A,但对要求3A或更高电流的解决方案而言,通常需要采用开关调节器。随着非隔离降压转换器拓扑学在这些开关电路中的不断使用,设计者要面对的第一个选择就是:设法获得完整的模块,或者创立自主的板上设计技术。由于基本的降压转换器相对比较简单,它包括1个 PWM、2个MOSFET、1个电感 和1个电容,因此这种简易性能够鼓励设计者拥有自主的板上设计技术。
第二种选择涉及使用何种半导体:集成器件或分立的解决方案。集成器件便于使用,是一种现存的解决方案。但是,如果性能和成本是考虑的首要问题,那么采用1个PWM IC 和分立的 MOSFET 是最佳的选择。如果高于 6A,就不应该选择单片式IC,所作出的选择应介于分立和集成功率元件之间。这里,有关成本和性能的界限不是很清楚,下面将作详细讨论。如果高于 20A, 就会有越来越多的 DSP涌入这一方向,因而要求多相设计 。
设计者一旦确定了电路在尺寸大小、效率、成本、热量控制、瞬时性能方面的要求,就可以开始选择元件。MOSFET在过去数年间经历了从TO220 发展到多种可用封装技术的漫长历程。目前,功率管理应用器件的热点是增强型SO8,装于普通 SO8 IC封装内的器件具有真正的功率处理能力。
增强型SO8
由于SO8 具有低矮外形和较好的芯片尺寸/封装比,让传统的功率封装如D2pak 和Dpak受益匪浅。但SO8存在的基本问题在于其本身是IC封装,没有真正的散热路径,于是半导体供应商由此发明了许多新的封装形式,如LFPak和QLPak。
LFPak类似于Dpak等传统的功率封装,但是由于Dpak引脚和内部引线的电感,设计频率始终无法突破200kHz 甚至更低的值。而LFPak 采用内部夹层构造,不再使用任何引线,从而在工作频率方面取得了重大突破,今天的硅片可达到2MHz 。
相对于LFPak,QLPak 提出了不同的主张:如果每个PCB的Si面积占大部分,那么QLPak就是最好的封装方式。但是,QLPak 内部构造中含有一个传统的用于同源极连接的焊接引线接点,因此同LFPak相比,最大频率将受到这种构造的限制。当然,较之Dpak,这种较短的焊接引线和无引脚结构实现了较低电感的封装,从而有可能成倍提高最大工作频率。
QLPak 在器件组装方面有所突破,因为它是第一个可升级的功率封装形式。只需用极少的资金,就可以对QLPak组装线进行重新配置,以生产不同封装尺寸的器件。在深入改进方面,飞利浦将采用无线源极接触方法,实现低电感的LFPak。
封装尺寸更小
Trench技术的改进意味着在封装方面实现了非常有吸引力的 MOSFET 规格,相对于SO8,封装尺寸更小。例如,一个双 TSSOP8 器件现在能够具有相当于三年前两个SO8的性能,而其封装尺寸只有SO8的大约 25%!诸如 TSOP6、SOT23、SC70等更小封装尺寸的产品将引申出一种称为微载体器件(MCD)的封装概念 ,对于基本的 MOSFET 开关,还出现了芯片级封装概念。
12下一页> 关键字:功率半导体 Trench MOSFET 本文链接:http://www.cntronics.com/public/art/artinfo/id/80005299
功率的整合
随着封装技术的进步,现在已经能够在同一封装内集成控制IC和功率MOSFET 器件,且不需要昂贵的构造技术,也不会影响产品的成品率。以下介绍了飞利浦运用HVQFN封装实现 PIP2xx范围的动力传输和全集成降压转换器的实例。
这些器件主要用于前面所讨论的相同负载点(PoL),它为分立的MOSFET赋予了各种不同的优点。例如,采用这种封装的全集成降压转换器具有与低电流单片式功率IC相同的优点:使用方便、可及时应对市场等。集成型功率器件的成本远不及分立型,但与其他集成产品相比,如果采用如上所述的基本构造,其成本就显得非常昂贵。
如果降压转换器的频率提高到1MHz甚至更高时,相对于分立产品,集成产品将显示出明显的性能优势。当频率在1MHz 及其以上时,在效率优化方面,门- 源环路的控制将变得特别关键。集成器件具有完整的回路,在单一的封装内可以进行各种控制,并通过电路解敏实现不同的布局变化。因此,含有1个高端 / 低端驱动器IC和2个MOSFET的简单产品将比任何分立解决方案的性能优越。
插图说明 :
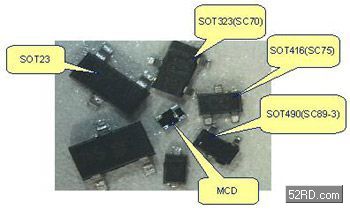
图1: 从未有过的小型封装, MCD是 MOSFET 封装的最终形式吗?
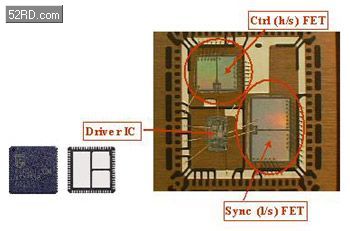
图2:飞利浦降压转换/动力传输集成器件的构造
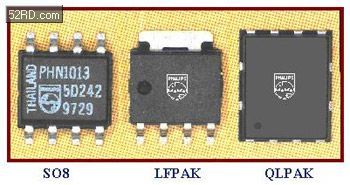
图 3: 尽管LFPak和 QLPak 的封装区域与SO8同为 6 ′ 5 mm,但这两种封装之间却存在明显的差异,详见下表2。

表 1:功率超时变化例子
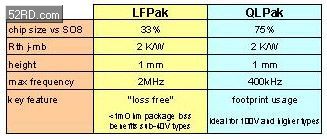
表 2: LFPak 与 QLPak 比较<上一页12 关键字:功率半导体 Trench MOSFET 本文链接:http://www.cntronics.com/public/art/artinfo/id/80005299?page=2
